În căutarea defectului util

A căuta defecte nu înseamnă a fi cârcotaş. Există cercetători în fizica materialelor care îşi consacră cariera acestui domeniu. Pentru ei perfecţiunea nu există, dar este şi inutilă. De ce? Pentru că proprietăţile materialelor sunt controlate tocmai de prezenţa acestor defecte.
La Institutul Naţional de Cercetare Dezvoltare pentru Fizica Materialelor (INCDFM) fiinţează un laborator dedicat acestei preocupări, căutarea şi caracterizarea defectelor în materiale. Sunt utilizate instalaţii ştiinţifice avansate: microscop electronic prin transmisie sau cu baleiaj, instalaţii de difracţie cu raze X, instalaţii de rezonanţă magnetică, microscop de forţă atomică etc.
Defecte extinse smart
Microscopia Electronică prin Transmisie (TEM) contribuie la caracterizarea defectelor extinse (dislocaţii, defecte planare) prezente în materiale, în cazul de faţă în siliciu. Depunerea unui strat monocristalin de Si pe un suport amorf nu este realizabilă folosind tehnicile de depunere consacrate. Soluţia, denumită „smart-cut”, constă în inducerea de defecte sub suprafaţa unei plachete de Si urmată de transferul fizic al stratului de Si de la suprafaţa plachetei pe suportul amorf. Tehnologia bazată pe implantarea ionică permite transferarea unor straturi de Si cu grosimi de cca 150-200 nm. Se doreşte, însă, obţinerea de straturi cu grosimi sub 100 nm, prin înlocuirea implantării ionice cu tehnici mai blânde, cum ar fi tratamentul în plasmă de hidrogen. În funcţie de parametrii plasmei, hidrogenul are două efecte asupra plachetelor de Si: corodarea suprafeţei şi inducerea de defecte structurale sub suprafaţa tratată. Aceste efecte pot fi vizualizate şi caracterizate numai prin TEM. Este necesară prepararea unor probe subţiri (sub 200 nm) pentru a putea fi transparente în fasciculul electronic al microscopului
La INCDFM este pusă la punct tehnica de subţiere începând cu tăierea probelor, şlefuirea mecanică până la grosimi de cca 20 şi finalizând cu subţierea ionică. Probele subţiate sunt studiate folosind microscopul electronic analitic JEOL 200 CX cu o tensiune maximă de accelerare de 200 kV (Fig. 1). Instrumentul poate fi operat în 3 moduri de bază: microscopie electronică prin transmisie (TEM), microscopie electronică cu baleiaj (SEM) şi analiză chimică elementală prin spectroscopie de raze X (EDS). Microscopul electronic a fost recent modernizat prin instalarea unei camere CCD pentru modul de funcţionare TEM. Microscopul permite, deci, achiziţia şi procesarea digitală a imaginilor TEM, SEM şi a spectrelor EDS. 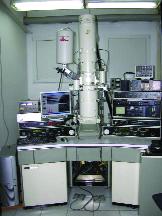
Fig. 1- Microscopul electronic
JEOL 200 CX TEM/SEM
din cadrul INCDFM
Defecte induse
Siliciul este un material cu structură cristalină cubică identică cu a diamantului. Investigarea prin TEM a plachetelor de Si hidrogenate a dus la evidenţierea a trei tipuri de defecte induse: defecte planare orientate pe planele {111} şi {100} ale reţelei cristaline a Si, precum şi cavităţi de dimensiuni nanometrice (Ł 20 nm). Din punct de vedere aplicativ, este interesant de studiat distribuţia acestor defecte în vecinătatea suprafeţei în funcţie de parametrii tratamentului în plasmă, urmărind favorizarea procesului de exfoliere „smart-cut”.
Studiul TEM aprofundat a inclus tehnici complementare de microscopie electronică, de la difracţia de electroni şi contrastul Bragg, până la tehnici cantitative de microscopie electronică de înaltă rezoluţie (QHRTEM), modelare structurală şi simulare de imagine.
Defectele planare de tip {100} nu se întâlnesc în materialele cu structura cubică a diamantului, iar defectele {111} prezintă caracteristici care le fac să difere faţă de defectele de împachetare obişnuite. Imaginea HRTEM a unui defect de tip {111} decorat cu hidrogen este arătată în Fig. 2a. Prin tehnici avansate QHRTEM bazate pe analiza de fază geometrică, am reuşit să măsurăm câmpul de deplasări atomice în reţeaua cristalină datorat prezenţei defectului (Fig. 2 b) şi să propunem un model structural al acestuia (Fig. 2c) 


Parerea ta conteaza: 

































.jpg) Academia Română a fost creată în 1866 pentru a cristaliza cele mai înalte valori intelectuale din provinciile românești într-o societate erudită menită să consolideze identitatea națională pe baza a patru componente esențiale: limbă și literatură, istorie, etnografie și cultură. La...
Academia Română a fost creată în 1866 pentru a cristaliza cele mai înalte valori intelectuale din provinciile românești într-o societate erudită menită să consolideze identitatea națională pe baza a patru componente esențiale: limbă și literatură, istorie, etnografie și cultură. La...








 Cercetări la INCDFM pe straturi subțiri pentru aplicații în spintronică
Cercetări la INCDFM pe straturi subțiri pentru aplicații în spintronică